在先进封装工艺的核心环节,ULVAC的溅射和去胶技术针对先进封装的特殊需求进行了深度优化。
灰化工艺
ULVAC的NA采用独特的等离子体处理方案,能够高效清除高密度互连结构中的光刻胶残留,同时保持底层介电材料的完整性。特别是在扇出型封装(Fan-Out)的RDL制程中,这种洁净处理能力可有效防止线路短路,提升良率。
我们的NA提供两种型号:一种兼容晶圆,另一种兼容面板。晶圆兼容型号采用晶圆尺寸无限制设计,可处理从下一代晶圆工艺到晶圆级封装的广泛制程,是半导体封装领域应用最广泛的设备。面板兼容型号支持最大600毫米方形的面板尺寸,即使在大尺寸面板上也能实现均匀的去胶处理和钛蚀刻工艺。
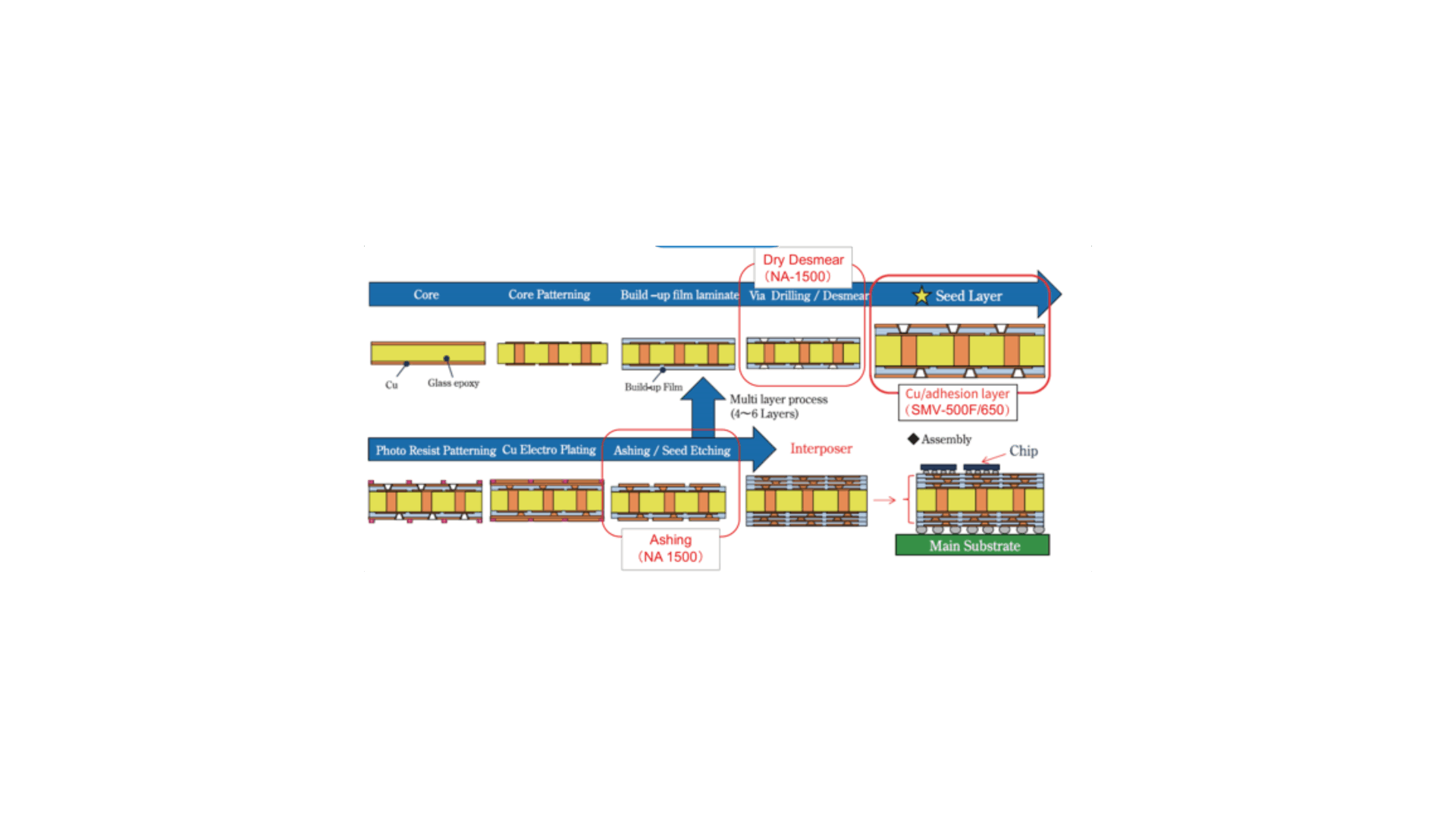
溅射技术三大核心优势
1、台阶覆盖性。通过创新的等离子体控制技术,可在TSV硅通孔和再布线层(RDL)等复杂结构表面实现均匀的铜/铝薄膜沉积,确保高深宽比结构的完整金属化
2、应力控制。精确的工艺参数调节使沉积薄膜具有理想的机械特性,避免因热膨胀系数不匹配导致的翘曲或分层问题
3、亚微米级的薄膜均匀性。这对2.5D/3D封装中微凸点(Microbump)的可靠互连至关重要,直接影响到最终产品的电性能和可靠性。
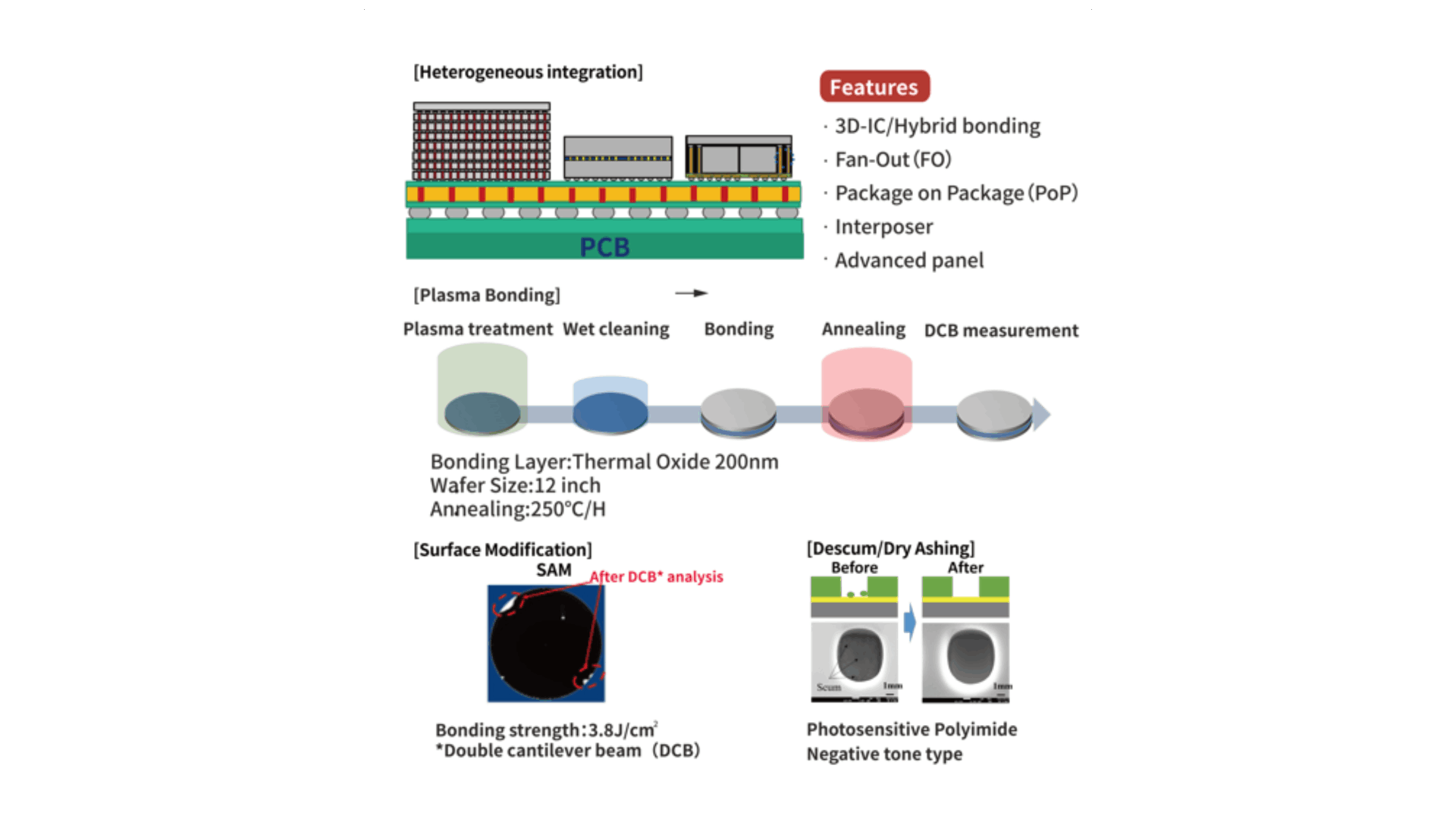
相关设备
工艺运用到的产品设备
溅射
-
Model:uGmni-300S
-
Model:SME
-
Model:SRH
-
Model:SMV
-
Model:SIV,SCV
-
Model:SIH,SCH
-
Model:SV
刻蚀
-
Model:uGmni-300S
CVD
-
Model:CME
PE-CVD
-
Model:CME
-
Model:uGmni-200C
-
Model:CC-200
解决方案
探索更多真空应用
解决方案

可以帮助您什么?
联系我们获取爱发科
解决方案、专家咨询
和合作机会